試料及び元素
フィルム上に成膜されたCr、Ni、Cu の膜厚分析
装置の概要
可搬式蛍光X 線分析装置OURSTEX100FA を図1 に示す。測定ヘッド部を成膜装置(図 3)に取り付けるため、図2 のようにインライン用に改造した。この測定ヘッド部内の検出器部およびX 線管球は水冷により放熱させた。

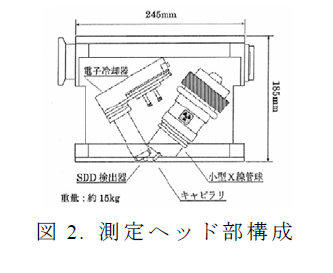
装置の取り付け

測定条件
- 装置:エネルギー分散型蛍光X線膜厚計
- X線管球ターゲット:W
- X線管球出力:40kV-0.25mA
- 検出器:ペルチェ冷却式(-10℃)SDD
- 測定雰囲気:真空(10-5Pa)
- 分析線:Cu-Kα Ni-Kα Cr-Kα
- (散乱線)(W-Lβ)
- 測定時間:100sec
- フィルム搬送速度:3.0m/min
検量線作成結果
標準試料は、予めICP 発光分析法により付着量(g/m2)を求め、各元素の密度(g/cm3)で除して算出したものを検量線用に使用した。図4 に測定波形を紹介する。
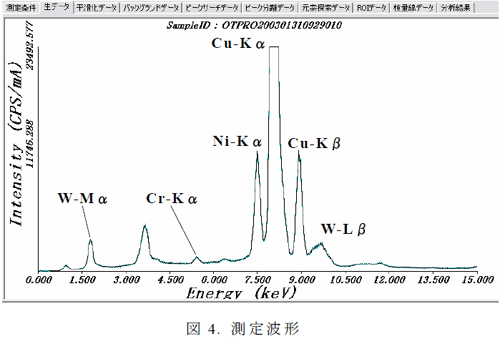

測定位置変動による補正
試料が搬送中には、測定位置の上下変動が生じ、定量誤差の要因になる為、レーリー散乱線( 今回では、W-Lβ 線) をリファレンスとして位置変動の補正を行った。
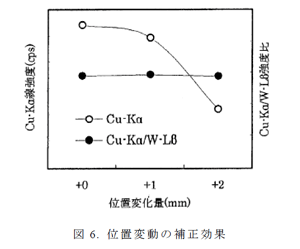
図6.より、位置変化量2mm 以内では、位置変動に関係なくほぼ一定値を示した。
Cu 層の吸収効果によるNi、Cr への影響
最外層になるCu 層の膜厚が変化した場合、その吸収効果が変化する為、Ni 及びCr 層の正確な膜厚測定が困難になる。その為、予めCu 層の厚みによるNi 及びCr の感度補正曲線を図7 に求めた。 (Cu 層膜厚が100nm の時の強度比を基準1.0 とした。)
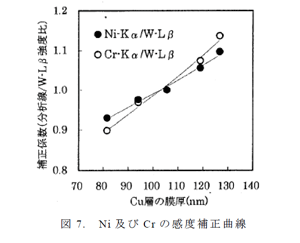
Cu 層の膜厚から、補正係数を求め、Ni 及びCr 層の厚みを補正し定量する。
検出限界
本装置におけるCr、Ni、Cu 膜厚の検出限界値( 理論計算値) を表2 に示す。

精度
フィルム位置を固定して測定した静的精度と、試料を搬送(3.0m/min)させながら測定した動的精度を表3 に示す。

まとめ
今回作製した蛍光X 線膜厚計を成膜装置に装着して性能評価を行った結果、
① 搬送に伴うフィルムの位置変動による誤差は、レーリー散乱線とのX 線強度比をとることで補正が可能であることがわかった。
② Cu、Ni 及びCr 膜の検出下限は、Cu が1.5nm であり、Ni 及びCr は、1nm 以下と高感度で得られた。
③ 測定精度は静的精度及び動的精度ともCV=5%以下であり、極薄膜を高感度で測定することが可能であった。
以上から、本膜厚計は、極薄膜厚のインライン測定に十分適用可能であると考えられる。また、膜厚測定のみならず、めっき液の分析等にも適用可能と考えられる。
推奨装置
エネルギー分散型蛍光X線分析装置「OURSTEX100FA」



